以工作電壓為70V、輸出電流為9A 的高壓大功率芯片 TO-3 封裝結構為例,首先基于熱分析軟件 Flo THERM 建立三維封裝模型,并對該封裝模型的熱特性進行了仿真分析。其次,針對不同基板材料、不同封裝外殼材料等情況開展對比分析研究。最后研究封裝體的溫度隨粘結層厚度、功率以及基板厚度的變化,得到一個散熱較優的封裝方案。仿真驗證結果表明,基板材料和封裝外殼的熱導率越高,其散熱效果越好,隨著粘結層厚度以及芯片功率的增加,芯片的溫度逐漸升高,隨著基板厚度的增加,芯片溫度降低,當基板材料為銅、封裝外殼為 BeO,粘結層 為 AuSn20時,散熱效果最佳。
電子封裝的作用主要是保護芯片、減小外界環境對芯 片的影響,并為其提供良好的電氣連接、機械支撐以及散熱路徑,對提高芯片的性能、使用壽命以及降低成本起到決定性的作用。由于 TO-3封裝具有功率大、散熱快、封裝工藝簡單等特點,故高壓大功率芯片大多采用 TO-3封裝。對于高壓大功率芯片,因其工作在高電壓、大電流的條件下,容易引起大量熱量的積累而造成器件的失效,元器件的失效率隨著結溫的升高呈指數上升。結溫每上升約10℃, 器件的壽命就會減少一半。因此,為了保證芯片的可靠 性,對封裝結構的熱仿真分析變得越發重要。
在散熱方面,對于不同的結構和材料,需要考慮如下4個環節的散熱問題,芯片到粘結層,粘結層到基板,基板到 冷卻裝置以及芯片到封裝外殼。這4個環節構成高壓大功率的傳熱通道,其中任何一個環節失敗都影響高壓大功率芯片的散熱,因此,要使封裝體具有良好的散熱特性并得到一個較好的散熱方案,深入研究有無基板時兩種封裝結構的溫度對比、不同基板材料、封裝外殼材料對封裝體散熱的影響以及功率、粘結層厚度和基板厚度對封裝結構溫度的影響有重要的意義。
本文首先針對高壓大功率芯片設計其封裝結構,基于 FloTHERM 熱分析軟件建立封裝模型,然后對該模型的散熱特性進行仿真分析。研究當采用不同基板材料、不同封裝外殼材料和改變芯片功率時封裝結構溫度的變化,最后研究當采用 BeO 陶瓷材料作為基板、AuSn20材料做粘結層、環氧樹脂做封裝外殼時,封裝體的溫度隨粘結層厚度、基板厚度的變化。
1 封裝結構的設計
針對高壓大功率芯片的封裝結構,選用 TO-3封裝,其封裝外形和封裝結構的內部剖面圖如圖1所示。
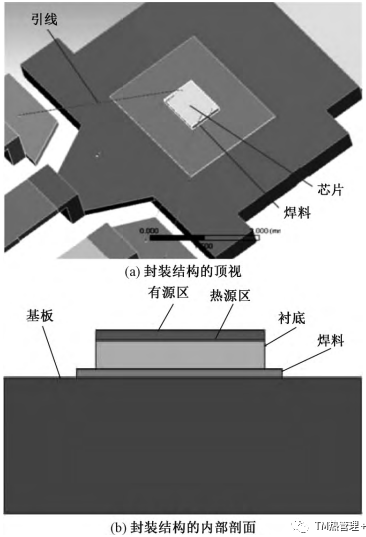
圖1 TO-3封裝結構
芯片的封裝是指利用微細加工技術,將芯片及其他相 關部分固定在框架或基板上,引出接線端子并通過可塑性 絕緣介質灌封固定,以構成整體立體結構的一種工藝。封裝的基本工藝流程包括如下幾步:芯片切割、芯片貼裝、芯片鍵合、成型、上焊錫和打碼等。從圖中可以看出,封裝結構主要由六部分組成,分別是基板、粘結層、芯片、引腳、 引線和封裝外殼。
基于 TO-3的封裝結構,利用 FloTHERM 熱分析軟件建立封裝模型,對模型進行仿真,為了簡化仿真,這里做一個近似,實際封裝中引線的形狀是彎曲的,根據引線的實際長度進行簡化,使其與坐標軸平行,并且由于引線的數量很多,詳細建模會耗費太多的計算資源,通過8個具有各向異性的長方體(cuboid)來簡化引線。模型中所設置的各組成部分的幾何尺寸如表1所示。
表1 模型各組成部分的幾何尺寸 (mm)
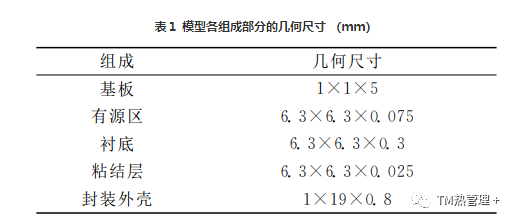
2 封裝模型的熱仿真分析
2.1 仿真條件的設置
基于實際的情況,仿真環境和邊界條件分別設置為:1)環境溫度為27℃;2)采用強迫空氣對流,芯片表面和基板表面都是通過風扇 進 行 對 流,忽略輻 射散熱,換熱系數為 10 W/m2·K;3)熱源的結構定義為 6.3×6.3× 0.075mm的立方體,由于該芯片的工作電壓為70V,輸出電流為9A,靜態功耗為125W,故定義模型中有源區的 功率為125 W。由于考慮基板和封裝外殼的熱傳導,對基板和封裝外殼進行網格約束,在基板厚度方向和封裝外殼厚度方向至少設置3個網格,這里皆設 置 為10,并且設置膨脹網格的距離為5%,保證系統網格在各模塊之間平滑過度。
2.2 不同的基板材料、封裝外殼材料對芯片散熱的影響
基于 TO-3的封裝結構,這里分別選取四種常用的基板材料和封裝外殼材料,將四種基板材料或封裝外殼材料依次嵌入仿真模型中進行仿真,當仿真不同的基板材料對芯片溫度的影響時,除了基板材料,模型其它組成部分的具體參數不變,同理,當仿真不同的封裝外殼材料對芯片 溫度的影響時,除了封裝外殼材料,模型其它組成部分的具體參數保持不變,選取的四種基板材料和封裝外殼如表2所示。
表2 四種基板材料和四種封裝外殼的參數

先仿真不同的基板材料對芯片溫度的影響,將模型中 基板模塊的材料屬性先定義為硅進行仿真,再定義為 AlN 進行 仿 真,然后又定義為BeO 進行仿 真,最后定義為 Al2O3進行仿真;然后仿真不同的封裝外殼材料對芯片溫度的影響,以環氧樹脂、AlSi、銅、鋁的順序分別進行仿真, 仿真結果如圖2所示。
從圖2可以得到,當基板材料為 Al2O3 時,溫度最高, 為140.82℃,Al2O3 的熱導率是四種基板材料中最低的, 基板材料為 BeO 時,溫度最低,為135.815 ℃,BeO 的熱導 率是四種基板材料中最高的;當封裝外殼為環氧樹脂時,封裝體的溫度最高,溫度為141.272℃,環氧樹脂的熱導率是四種封裝外殼材料中最低的,封裝外殼為銅時,溫度最低, 為135.815℃,銅的熱導率是四種封裝外殼材料中最高的。因此,從圖2中可以知道,材料的熱導率越高,封裝結構的溫度越低,散熱效果越好。
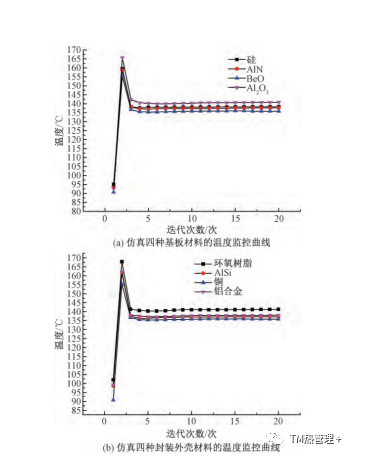
圖2 仿真不同基板材料、封裝外殼的溫度監控曲線
2.3 芯片溫度隨功率變化、基板厚度、粘結層厚度的變化
當芯片的功率發生變化時,芯片的溫度會改變,設置芯片的功率從 110 W 變到 130 W,分別仿真了環境溫度為27℃和85 ℃時芯片溫度隨功率變化的情況,仿真結果如 圖3所示。
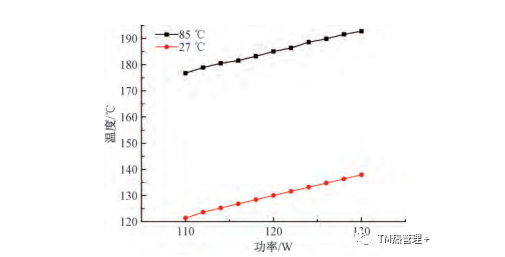
圖3 芯片溫度隨功率的變化
從圖3知,封裝體的溫度隨芯片功率的增加而升高,功率越大,芯片的溫度越高。
為了研究芯片溫度隨基板厚度的變化情況,這里設置 基板厚度從1~20mm,對表2中的四種基板材料進行仿真 對比,結果如圖4所示。
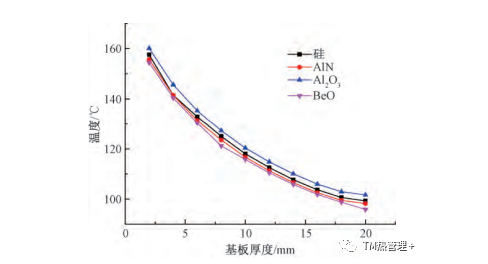
圖4 芯片溫度隨基板厚度的變化
從圖4得到,在1~20mm 之間,芯片的溫度隨基板厚度的增加而降低,基板越薄,芯片的溫度越高,變化越急劇, 隨著基板厚度的增加,溫度逐漸降低,且溫度的變化越來越來緩慢,從圖4也可以看出,基板材料的熱導率越高,散熱特性越好。
粘結層的作用是將芯片固定于封裝基板上,由于其熱 導率較低,芯片散熱受到很大限制,其厚度的改變對芯片的散熱也有很大的影響,為了研究粘結層厚度對芯片散熱的影響,設置粘結層的厚度從0.015mm 到0.085mm,對模 型進行仿真。并且這里選擇了三種粘結層材料進行對比仿真,分別是錫鉛銀、導電環氧樹脂、AuSn20,其熱導率分別為50W/(m·K)、0.8W/(m·K)、57W/(m·K)。仿真結果如圖5所示。
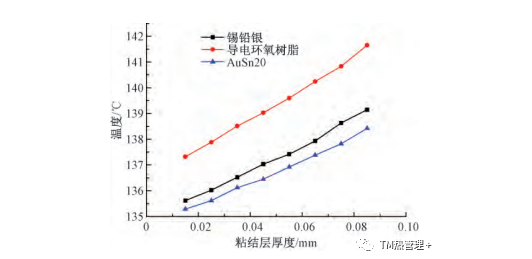
圖5 芯片溫度隨粘結層厚度的變化
從圖5得到,芯片的溫度隨著粘結層厚度的增加而升 高,并且粘結層材料的熱導率越低,芯片的溫度上升越快,材料的熱導率越高,散熱特性越好,芯片溫度的變化相對緩慢。
2.4 仿真結果的分析
由仿真結果知,芯片的溫度隨功率和粘結層厚度的增 加而升高,隨基板厚度的增加而降低;并且材料的熱導率越高,其散熱效果越好。從仿真結果得到,當模型中的基板材料為銅、封裝外殼為 BeO,粘結層 為 AuSn20時,散熱效果最佳,模型中各組成部分的具體參數如表3所示。
表3 模型各組成部分的材料和熱導率

對模型進行熱仿真,其溫度顯示平面圖如圖6所示。

圖6 整體封裝結構的熱場分布仿真結果
從圖6可以看出,最高溫度為136℃,位于芯片有源區的中央,向四周溫度逐漸降低,從圖6c可以看出,溫度沿著基板方向逐漸降低,傳熱的路徑為芯片到粘結層,粘結層到基板,最后傳到環境中,圖中紅色表示最高溫度區域。若把銅金屬外殼換成環氧樹脂外殼,其溫度顯示平面圖將如圖7所示。
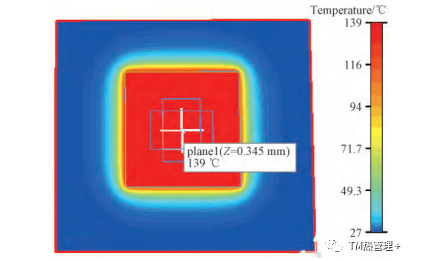
圖7 模型中用環氧樹脂做外殼時的溫度顯示平面圖
從圖7可以看出,若把封裝外殼材料換成環氧樹脂,封 裝體的溫度變高,從136 ℃升到139 ℃,溫度上升了3℃, 環氧樹脂的熱導率比銅要低很多,熱導 率越低,傳熱越困難,芯片的溫度越高。若把基板材料換為 AlN,其溫度顯示平面圖將如圖8所示。
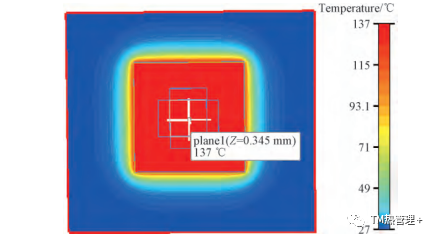
圖8 模型中用 AlN 做基板材料時的溫度顯示平面圖
從圖8可以看出,當基板材料由 BeO 陶瓷基板更換為 AlN 陶瓷基板時,封裝模型的溫度變為137℃,比基板材料 為 BeO 時升高了1 ℃,可以看出,基板材料熱導率的高低 對散熱有很大的影響。在對模型整體結構的仿真過程中, 各組成模塊幾何尺寸的設置如表1所示,由圖4、5知,增加基板厚度和稍微減小粘結層的厚度,封裝體的溫度將會更低,根據實際封裝的需要,選取合適基板的厚度、粘結層的 厚度以及封裝外殼材料,便可以得到一套散熱效果較佳的 封裝方案。
3 結論
本文分別仿真了不同基板材料、不同封裝外殼材料對 芯片散熱的影響以及仿真了芯片溫度隨功率、基板厚度以及粘結層厚度的變化,最后得出一個散熱較好的封裝方案。結果表明:基板材料和封裝外殼的熱導率越高,其散熱效果越好;封裝體的溫度隨基板厚度增加而降低,隨功率的增加和粘結層厚度的增加而升高;最后得出散熱效果最佳的封裝方案為采用 BeO 陶瓷材料做基板、AuSn20材料做粘結焊料、銅做封裝外殼。
來源:電子測量技術
作者:楊勛勇1 楊發順1 胡 銳2 陳 瀟2 馬 奎1
1.貴州大學大數據與信息工程學院
2.貴州振華風光半導體有限公司
