半導體產業網訊:從西安電子科技大學微電子學院官網獲悉,近期,西安電子科技大學郝躍院士團隊張進成教授、周弘教授等在超寬禁帶半導體氧化鎵功率器件研究方面取得重要進展,研制出一種新型的空穴超注入p-NiO/n-Ga2O3半導體異質結二極管。該結構通過異質結空穴超注入效應,實現了兼具超高耐壓和極低導通電阻的氧化鎵功率二極管,功率優值高達13.2GW/cm2,是截止目前氧化鎵半導體器件的最高值。相關成果以《Ultra-wide bandgap semiconductor Ga2O3power diodes》為題發表于國際期刊《自然·通訊》(Nature Communications)。

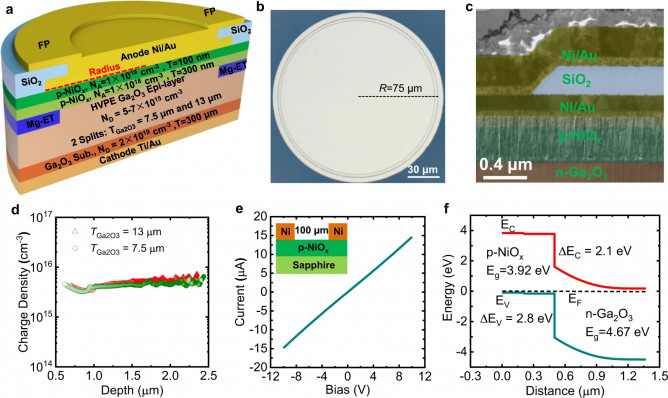
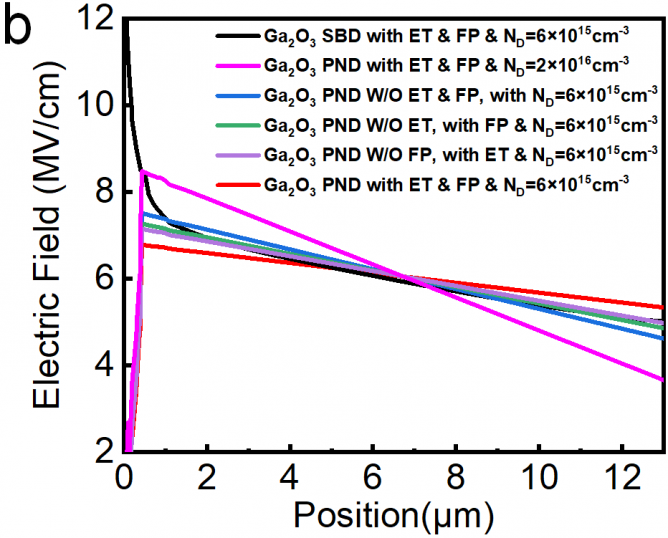
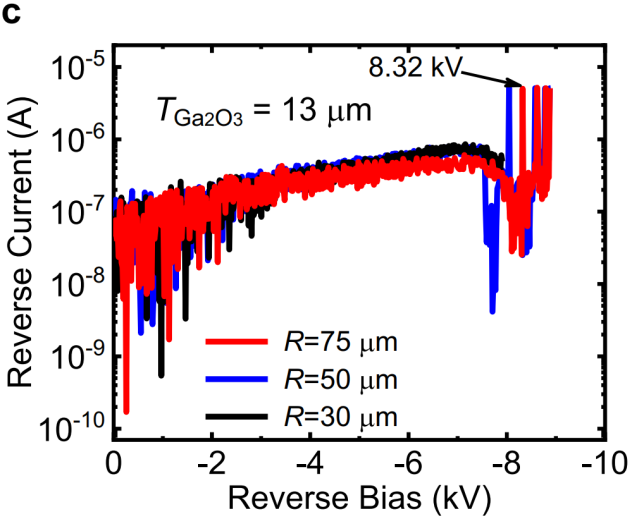
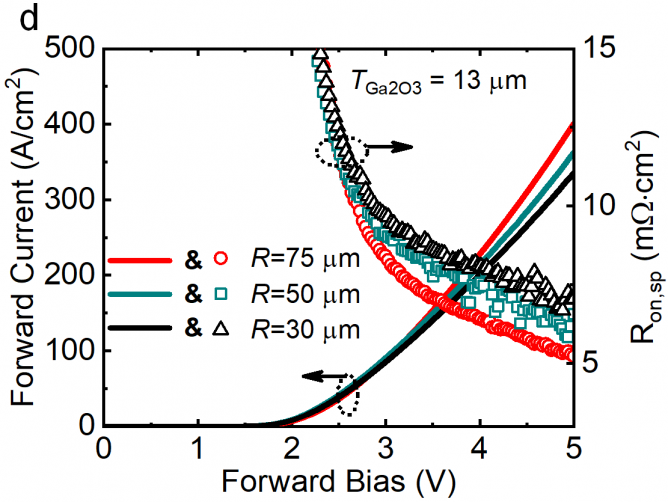
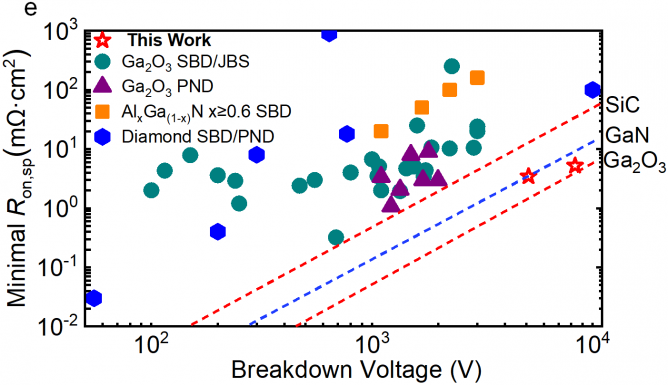

氧化鎵(β-Ga2O3)是超寬禁帶半導體的典型代表,禁帶寬度高達(~4.8 eV),臨界擊穿場強高達(~8 MV/cm),是研制高耐壓、大功率和高效節能半導體器件的理想半導體材料之一,可實現高擊穿、低功耗和低成本器件芯片三重優勢,在電力傳輸轉換、電動汽車、高鐵等領域具有重大應用前景。與當前產業界火熱的第三代半導體GaN和SiC相比,Ga2O3功率器件在相同耐壓情況下具有更低的導通電阻,應用于電能轉換領域將實現更低的功耗和更高的轉換效率。因此,近年來,氧化鎵半導體已成為半導體國際研究熱點和大國技術競爭制高點。
2018年以來,在郝躍院士領導下,西安電子科技大學通過自主氧化鎵生長MOCVD設備、高質量氧化鎵外延材料、高壓器件新結構與新工藝等一系列技術創新,實現了氧化鎵功率二極管和功率晶體管性能的高速提升,如圖1和2,取得了多項里程碑成果,使我國氧化鎵功率器件研究水平進入國際前列。

圖1 西安電子科技大學氧化鎵功率二極管研究進展

圖2 西安電子科技大學氧化鎵功率晶體管研究進展
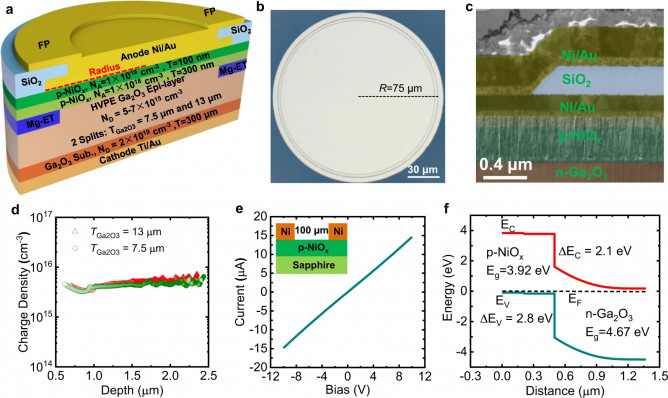
圖3 西安電子科技大學氧化鎵功率晶體管研究進展
由于p型摻雜困難,空穴遷移率低,氧化鎵功率器件中載流子雙極輸運及其電導調制效應始終沒有實現,這是制約氧化鎵功率器件性能進一步提升的關鍵瓶頸。為此,本文構筑了一種新型p-NiO/n-Ga2O3異質型PN結二極管結構。一方面,通過將PN異質結、鎂注入終端、高k/低k泊松終端場板等相復合,利用高溫熱退火抑制非故意摻雜,使器件峰值電場強度得到極大的削弱;為高耐壓氧化鎵器件發展開拓了新技術途徑,實現了8.3 kV的超高耐壓。另一方面,得益于低導帶帶階PN異質結的設計,超寬禁帶PN異質結功率二極管實現了較低的開啟,正向偏置時,空穴勢壘降低,p區空穴躍過PN異質結進入n區,當空穴濃度高于電子濃度后,誘導電子濃度上升,從而顯著降低了器件導通電阻,隨著正向電壓的增加微分電阻持續降低,在氧化鎵器件中實現了空穴超注入效應。研制的氧化鎵功率二極管擁有超高耐壓和極低電阻,功率優值P-FOM高達13.2 GW/cm2,是截止目前氧化鎵半導體器件的最高值。
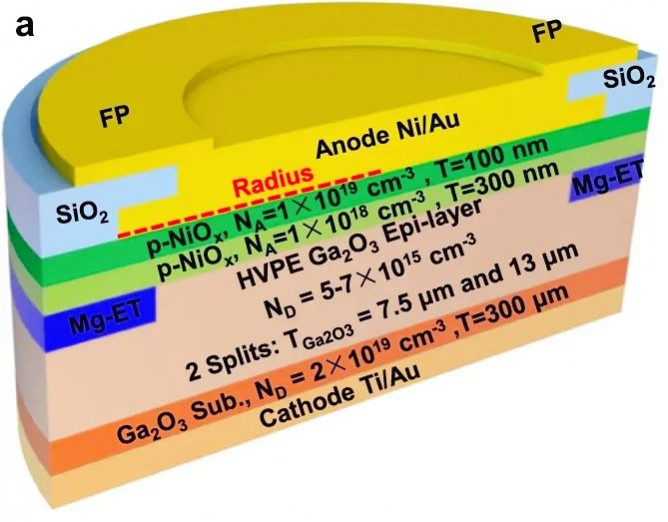
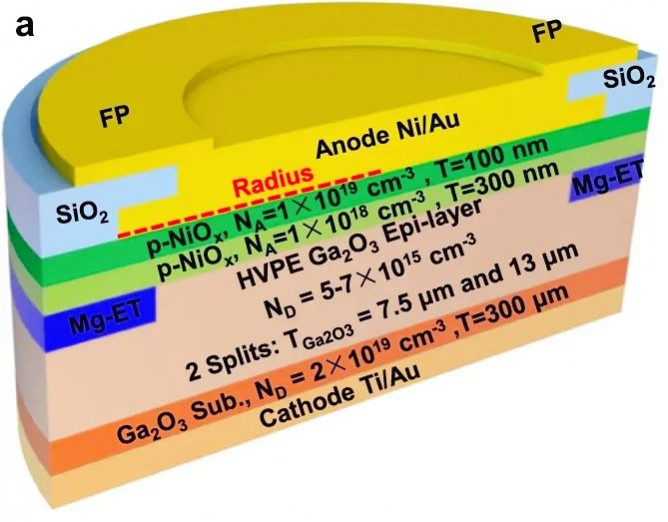
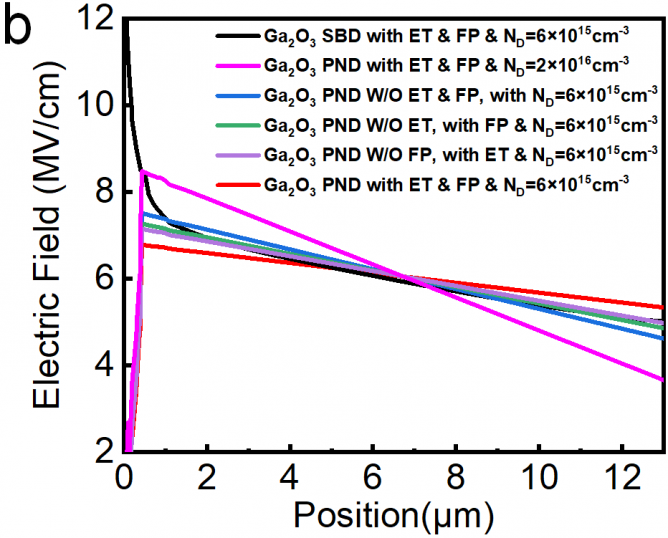
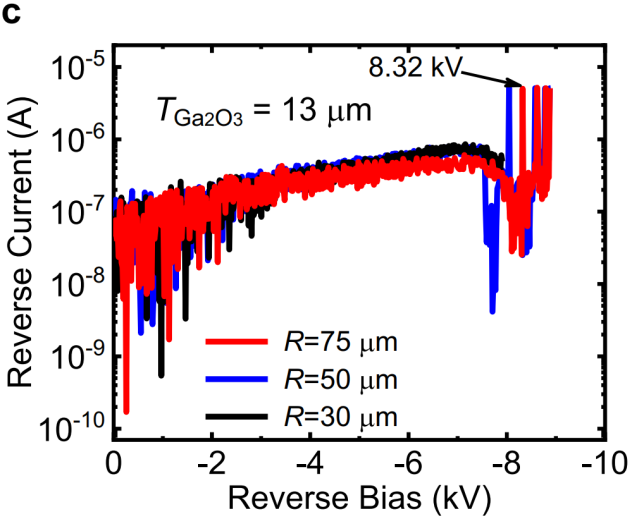
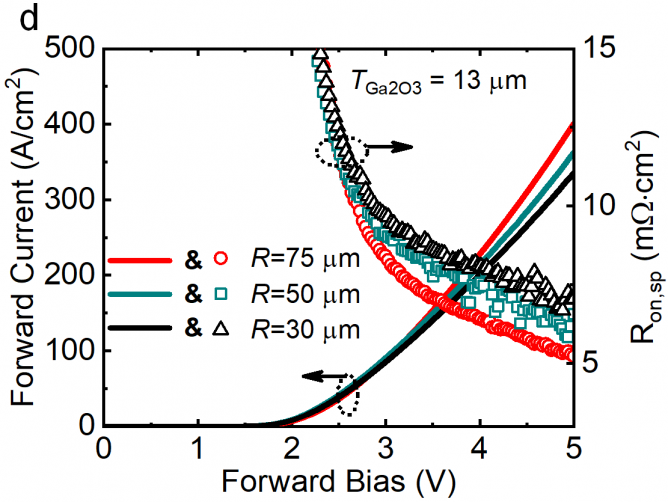
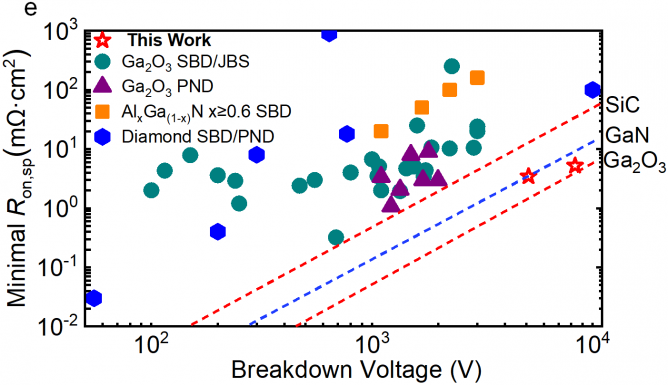
圖4 (a)器件三維結構示意圖,(b)不通器件結構在8.3 kV耐壓時仿真所得電場圖,(c)器件擊穿圖,(d)器件正向導通圖,(e)超寬禁帶半導體功率器件導通電阻-耐壓對比圖。
