
目前,p-GaN帽層技術是實現增強型GaN基高電子遷移率晶體管(high electron mobility transistor,HEMT)的主流商用技術,但Mg摻雜難激活以及刻蝕損傷等因素限制了器件性能的進一步提升,因此高性能、低成本的增強型帽層技術具有重要的研究意義。
近日,西安電子科技大學張進成教授等人在SCIENCE CHINA Materials發表研究論文,采用p型氧化亞錫(p-SnO)代替p-GaN作為柵帽層引入AlGaN/GaN HEMT,并通過Silvaco器件仿真和實驗驗證兩方面系統研究了器件的電學性能。
仿真結果顯示,通過簡單改變p-SnO的厚度(50-200 nm)或摻雜濃度(3 × 1017-3 × 1018 cm?3),可以實現器件閾值電壓在0-10 V范圍內連續可調,同時器件的漏極電流密度超過120 mA mm?1,柵擊穿和器件擊穿電壓分別達到7.5和2470 V。
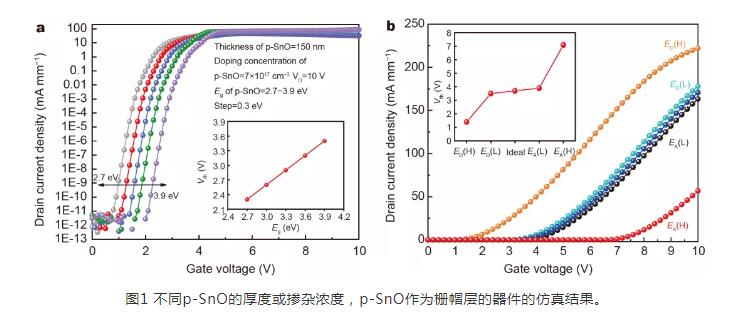
在此基礎上,制備了基于磁控濺射p-SnO帽層的AlGaN/GaN HEMT,未經優化的器件測得了1 V的閾值電壓、4.2 V的柵擊穿電壓和420 V的器件擊穿電壓,證實了p-SnO薄膜作為增強型GaN基HEMT柵帽層的應用潛力,為進一步提升增強型AlGaN/GaN HEMT性能,同時降低成本奠定了基礎。
文章信息
Dazheng Chen, Peng Yuan, Shenglei Zhao, et al. Wide-range-adjusted threshold voltages for E-mode AlGaN/GaN HEMT with a p-SnO cap gate. SCIENCE CHINA Materials, https://doi.org/10.1007/s40843-021-1838-3
