近日,中國科技大學微電子學院楊樹教授和龍世兵教授課題組在垂直型GaN功率晶體管研究方向取得進展,實現了具有高反型溝道遷移率的垂直型GaN溝槽柵MISFET,相關研究成果以“Achieving 205 cm2V-1s-1?Inversion Channel Mobility in 1.4 kV Vertical GaN-on-GaN MISFET With Nitride Gate Dielectric?”為題在2024 IEEE?International Electron Devices Meeting (IEDM)上做口頭報告。IEDM是電子器件領域的國際知名會議,本屆會議于2024年12月7日至11日在美國舊金山舉行。
千伏級功率器件在光伏、工業電機、電動汽車、醫療供電等領域具有廣闊應用前景。垂直型GaN-on-GaN功率器件能夠拓展傳統GaN器件的電壓和功率等級,并具有優異的散熱和動態性能。當前,在多數1.2~1.7 kV寬禁帶半導體溝槽柵MOSFETs中,因反型溝道遷移率難以提升,溝道電阻通常占器件整體導通電阻的~30%或以上。為了降低器件導通電阻和損耗、提升功率轉換效率,需要探索功率MOSFET中反型溝道遷移率的有效提升方法。
研究團隊通過優化柵槽刻蝕工藝,實現了低粗糙度、清潔光滑無微溝槽的柵極溝槽,可抑制表面粗糙度散射;同時在柵介質沉積系統中原位生長高質量AlN界面插入層,可將界面陷阱密度降低約一個數量級,可抑制庫侖散射。器件結構示意圖及溝槽柵MIS界面如圖1所示。
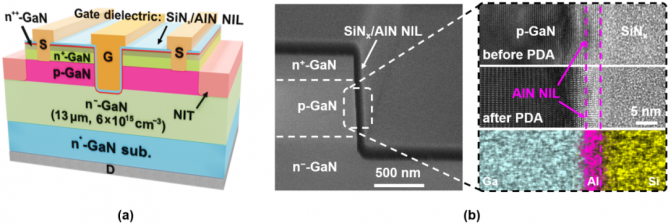
圖1. 具有AlN界面插入層的垂直型GaN-on-GaN溝槽柵MISFET:(a)?器件結構示意圖;(b)器件柵槽處SEM、TEM及EDS表征結果。
具有AlN界面插入層的垂直型GaN功率MISFET導通電阻~2.0 mΩ·cm2,閾值電壓~4.1V,電流擺幅~1010,擊穿電壓~1.4 kV。通過AlN界面插入層對溝道載流子散射機制的抑制,無需復雜再生長工藝,即可將溝槽柵反型溝道遷移率從30 cm2/V·s提升至205 cm2/V·s,在當前國際報道的千伏級同類器件中較為領先。器件導通特性和溝道遷移率提取結果如圖2所示。
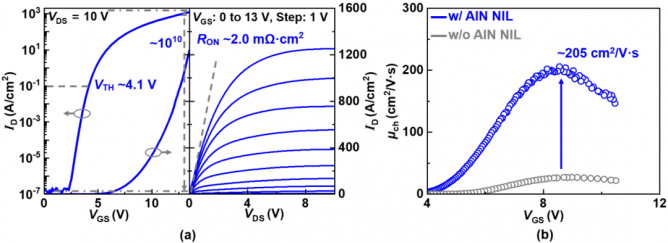
圖2. 具有AlN界面插入層的垂直型GaN-on-GaN溝槽柵MISFET:(a)導通特性;(b)反型溝道遷移率提取結果。
中國科技大學微電子學院博士生韓在天為論文第一作者,楊樹教授為論文通訊作者,龍世兵教授為合作教授。該研究工作得到了國家重點研發計劃、國家自然科學基金等項目的資助。
來源:中國科大微電子學院
